article detail
이석준 아이티아이 대표 “'無 손상 절단'으로 AI 반도체 패키징 기여”
2026. 4. 7. 오전 8:30

AI 요약
차세대 AI 반도체의 HBM 적층수를 높이려면 유리기판을 손상 없이 깨끗이 절단해야 하며 절단 과정의 미세 균열이나 이물질은 제품을 무용지물로 만들 수 있습니다. 아이티아는 레이저로 절단 부위를 급속 가열한 뒤 특수 냉매로 냉각·수축시키는 열충격 방식의 파인컷(Fine Cut) 기술로 금이나 깨짐 없는 무손상 절단을 구현하고 있으며 20~35마이크로미터(㎛) HBM 웨이퍼도 무손상으로 전달할 수 있는 기술을 확보했다고 밝혔습니다. 이 회사는 2020년 폴더블 유리 사업에서 상용화에 실패한 뒤 투자자를 찾아 재기했고 현재 반도체 대기업과 기술 협의를 진행하며 장비 공급이나 기술 라이선스 등으로 사업을 추진할 계획입니다.

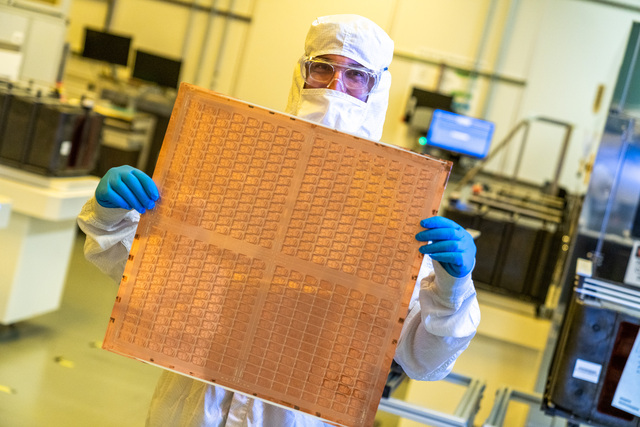





![HBM 주도권 흔들리나…SK하이닉스, 낸드·차세대 기술로 반격 [AI칩 인사이드]](https://img1.daumcdn.net/thumb/S1200x630/?fname=https://t1.daumcdn.net/news/202604/09/552782-ZYLYaJX/20260409060029410nghb.png)
![삼성 ‘AI 반도체 플랫폼’ 위한 조건들[포럼]](https://wimg.munhwa.com/news/cms/2026/04/08/news-p.v1.20260408.aaf61ec7252c40569b81a9244210fb8b_R.jpg)


